Intels Durchbruch ermöglicht eine Fortsetzung der Skalierung und fördert Moores Gesetz: Glas-Substrate für fortschrittliche Packaging-Technologien kommen noch in diesem Jahrzehnt. Dabei reichen Intels Forschungen und Arbeiten an dieser Technologie bereits ein Jahrzehnt zurück. In Chandler (Arizona) hat Intel mittlerweile eine voll integrierte Glas-F&E-Linie mit über 1 Milliarde Dollar Investitionssumme gebaut. Die Glas-Substrate ermöglichen eine Größenordnung an Verbesserungen in den Designregeln, die für zukünftige Datacenter- und KI-Produkte benötigt werden. Sie bieten enorme Leistungs- und Dichte-Steigerungen gegenüber organischen Substraten.

Chip-Architekten können somit mehr „Chiplets“ auf einem kleineren Grundriss in einem Paket unterbringen. Deutlich vebesserte mechanische, physikalische und optische Eigenschaften erlauben mehr Transistoren für eine bessere Skalierung und Zusammenstellung von größeren Chiplet-Komplexen. In Ergänzung dazu führen Verbesserte Dichte- und Leistungseigenschaften zu geringeren Gesamtkosten und einem niedrigeren Energieverbrauch. Chip-Architekten erhalten somit eine größere Flexibilität in ihren Designs.
Intels Schwerpunkte bei den Glas-Substraten:
- Enge Zusammenarbeit mit Ausrüstungs- und Materialpartnern zur Ermöglichung eines homogenen Ökosystems
- Elektrisch funktionale, zusammengebaute MCP-Testaufbauten mit 3 Schichten von RDL und TGV mit 75 µm
- Gefüllte Durchglas-Vias mit einem Aspektverhältnis von etwa 20:1 für eine Kerndicke von 1 mm, die für KI und Datacenter geeignet sind
- Über 600 Erfindungen in Bezug auf Architektur, Prozess, Ausrüstung und Materialien
Warum Glas gegenüber Organics?
- Höhere Temperaturtoleranz bietet 50% weniger Muster-Verzerrung
- Glas-Substrate haben eine ultra-niedrige Ebenheit, die eine verbesserte Schärfentiefe für die Lithographie ermöglicht
- Dimensionale Stabilität, die für extrem enge Schicht-zu-Schicht-Interconnect-Überlagerungen erforderlich ist
- Bis zu 10-fache Erhöhung der Interconnect-Dichte mit Glas möglich
- Verbesserte mechanische Eigenschaften von Glas ermöglichen ultra-große Formfaktor-Pakete mit sehr hohen Montageausbeuten
- Glas bietet verbesserte Flexibilität bei der Festlegung von Designregeln für die Stromversorgung und Signalrouting
- Möglichkeit zur nahtlosen Integration optischer Interconnects sowie zur Einbettung von Induktoren und Kondensatoren in das Glas bei höheren Temperaturverarbeitungsprozessen
- Bessere Lösungen für die Stromversorgung bei gleichzeitiger Erreichung einer Hochgeschwindigkeits-Signalübertragung, die bei viel niedrigerer Leistung benötigt wird.
Die nachfolgenden Folien enthalten weitere Details und Bildmaterial zum Thema Glas-Substrate:
Glass Core Substrate
Intels Montage- und Testtechnologie-Entwicklungsfabriken in Chandler, Arizona, im Juli 2023
Intels fortschrittliche Packaging-Technologien werden in den Montage- und Testtechnologie-Entwicklungsfabriken des Unternehmens realisiert. Eine kurze Fotostrecke zeigt noch einmal ein paar Eindrücke zur neuen Fertigung. Auf dem ersten Bild hält inder der Intel-Ingenieure ein Test-Glas-Kern-Substrat-Panel in die Kamra.
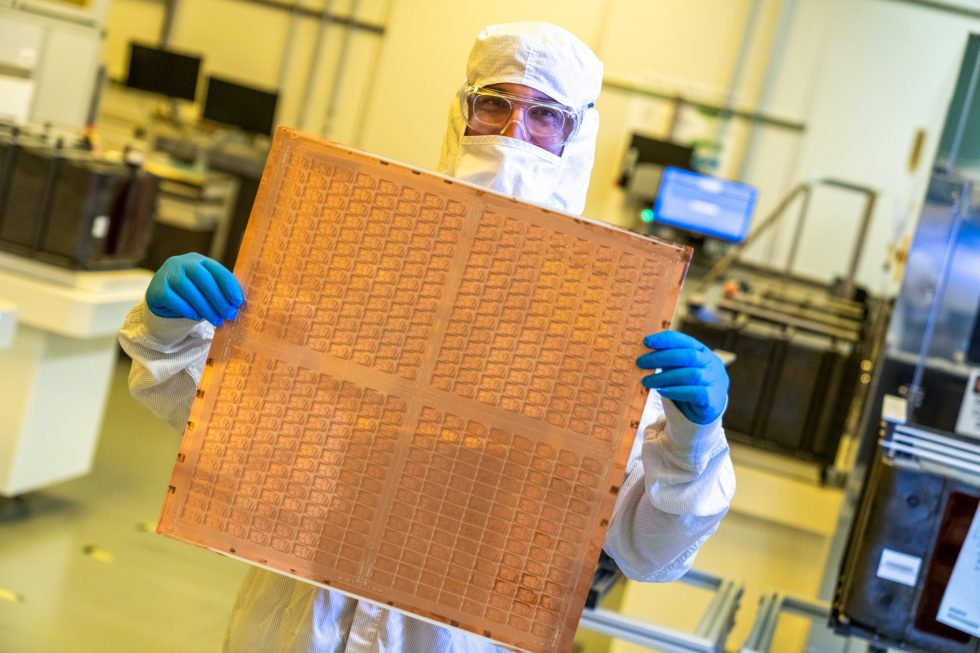
Das nächste Foto zeigt Testeinheiten aus Glas-Substrat in Intels Montage- und Testtechnologie-Entwicklungsfabriken in Chandler, Arizona, im Juli 2023
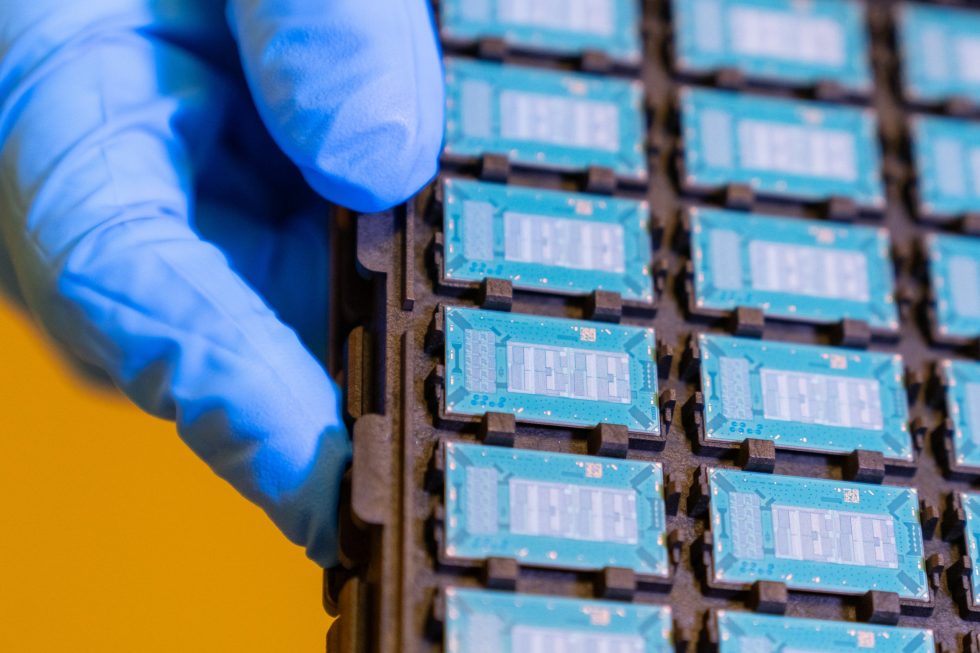
Ein Intel-Ingenieur arbeitet an einem Werkzeug zum Entfernen des Lithographieresists von Glas-Kern-Substraten.
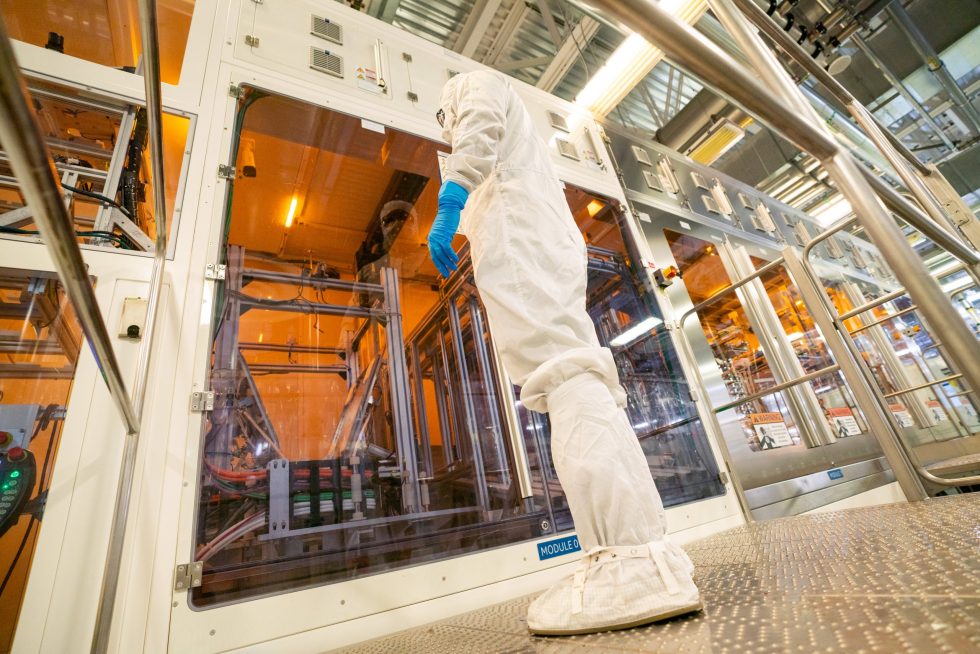
Das nächste Foto zeigt die Ball Grid Array-Seite eines von Intel zusammengebauten Glas-Substrat-Testchips…

…und das nächste die Multi-Die-Montageseite eines von Intel zusammengebauten Glas-Substrat-Testchips.
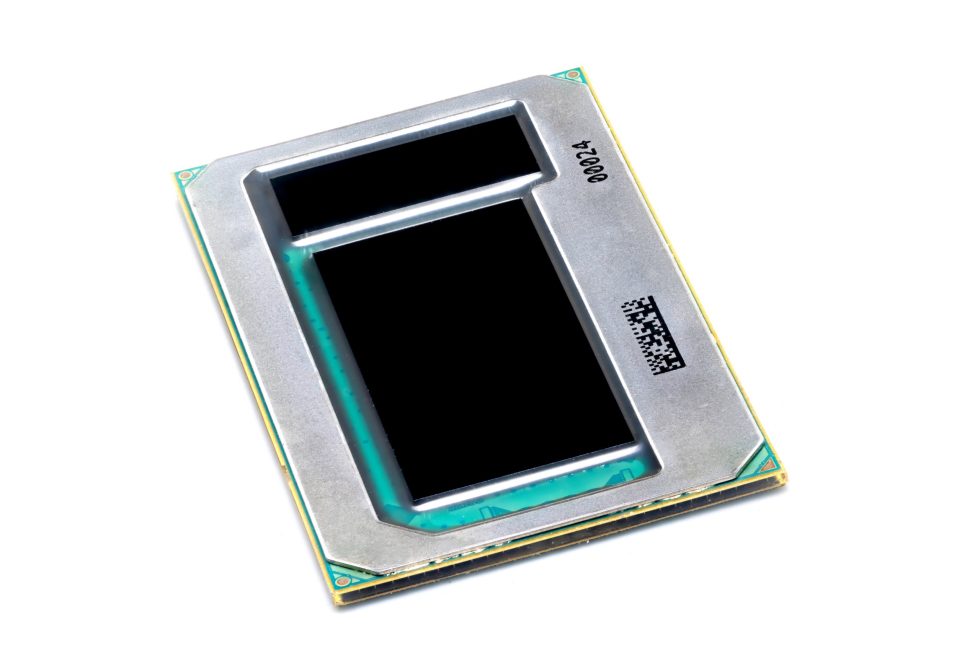
Hamid Azimi, Corporate Vice President und Direktor der Substrattechnologie-Entwicklung bei der Intel Corporation, hält einen von Intel zusammengebauten Glas-Substrat-Testchip in die Kamera.

Die Text- und Bildmaterialien wurden von Intel unter BDA zur Verfügung gestellt. Bedingung war die Einhaltung der Sperrfrist bis zum 18. September 2023 um 15.00 Uhr.
































6 Antworten
Kommentar
Lade neue Kommentare
Urgestein
Veteran
Urgestein
1
Urgestein
Urgestein
Alle Kommentare lesen unter igor´sLAB Community →