Worum geht es und was ist ein Package?
Da man die GPU (und in diesem Falle auch den Interposer mit GPU und Speicher) nicht so einfach auf das PCB löten kann, werden diese Komponenten zunächst erst einmal durch einen der dafür spezialisierten Fertiger (z.B. ASE auf Taiwan) auf ein sogenanntes Package im Flip-Chip-Verfahren verfrachtet („Packaging-Prozess“), welches sich später in den Fabriken deutlich einfacher verarbeiten lässt.
Dazu muss man wissen, dass diese Packages im SMT-Verfahren ja maschinell von einer Rolle auf einer Art Transferband zugeführt und dann auf dem PCB positioniert werden. Doch genau da gab es bereits im Vorfeld ernstzunehmende Probleme, weil viele, vor allem ältere SMT-Anlagen, nicht in der Lage waren, diese hochempfindlichen Komponenten ohne Schäden zu transportieren und zu positionieren. Soweit die Theorie…
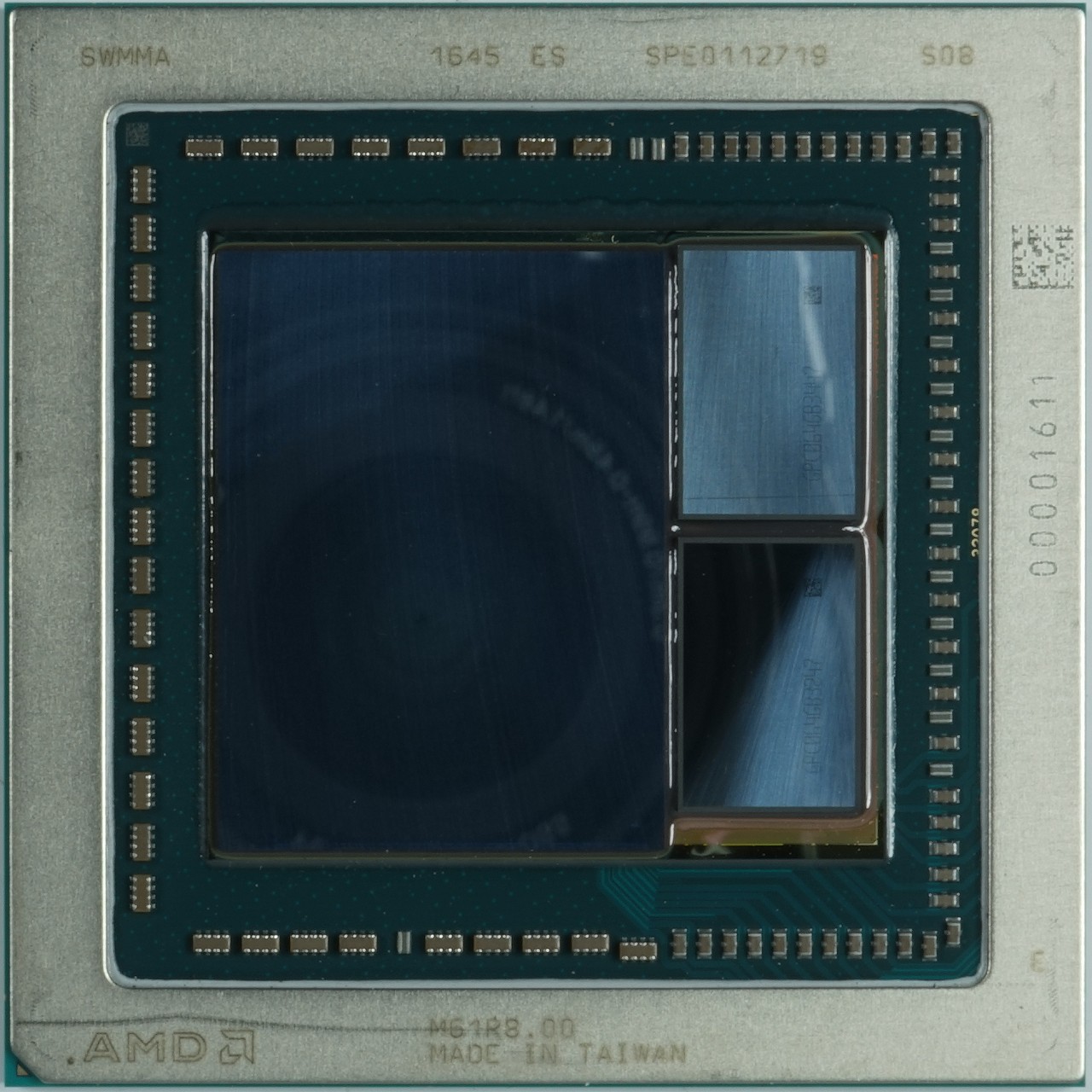 Die Mutter der Vega-Packages: unvergossen und made in Taiwan
Die Mutter der Vega-Packages: unvergossen und made in Taiwan
Doch vergleichen wir zunächst einmal das Package, so wie es anfänglich auf AMDs internen Folien und Vorführungen genutzt wurde (Bild oben) und wie wir es in ähnlicher Form auch auf unserer RX Vega56 vorfinden. Wir können erkennen, dass zwischen GPU und den beiden Speichermodulen, wie schon bei Fiji, tiefere Spalte bestehen, bzw. diese Komponenten relativ hoch sind.
Der Interposer hingegen ist extrem dünn und vor allem zerbrechlich. Deshalb wohl auch die Warnung in den Folien von AMD für die Entwickler und die Industrie, sowie alle intern Beteiligten, z.B. beim Entfernen alter Wärmeleitpaste während der Entwicklungsphase sehr vorsichtig zu Werke zu gehen.
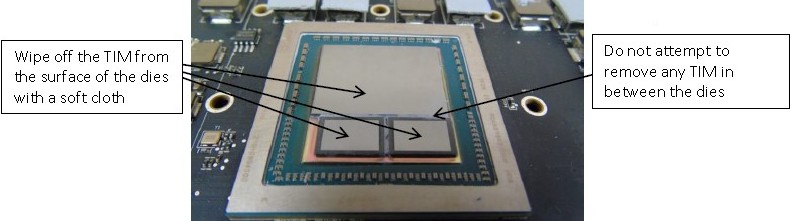
Unterschiede zwischen den einzelnen Packages
Für eine maschinelle Fertigung ist so etwas natürlich ebenfalls ziemlich riskant, zumal man auch auf sogenannte „Underfill“-Probleme stoßen kann, da sich beim Packaging immer auch druckempfindliche Hohlräume zwischen Interposer und Zwischenplatine bilden können. Dem kann man entgegenwirken, indem man zusätzlich auf das sogenannte Molding setzt, also das zusätzliche Vergießen der Chips und Speichermodule auf dem Interposer. Betrachten wir nun das Schema für jede der beiden Varianten:
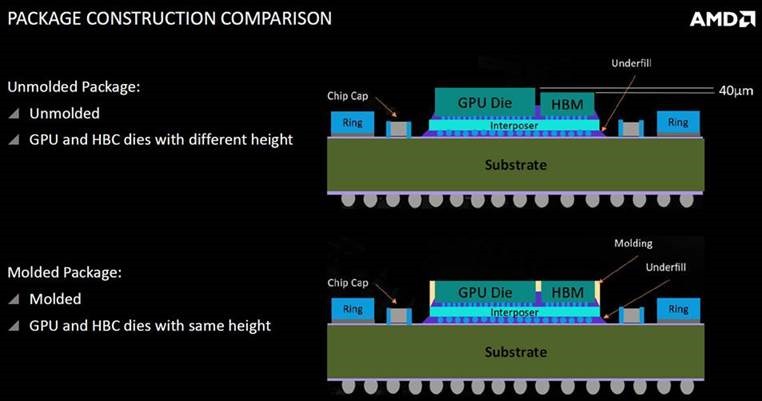
Betrachtet man allerdings das aktuell auf der Vega FE und einigen RX Vega verwendete Package (Bild unten), dann sieht man deutlich, dass AMD hier nunmehr auf das Molding setzt. Der Bereich um GPU und Speicher wurde großflächig mit einem geeigneten Material ausgegossen, was die Stabilität deutlich erhöht. Auch dieses Packages sind wiederum Made in Taiwan und werden bei ASE gefertigt.
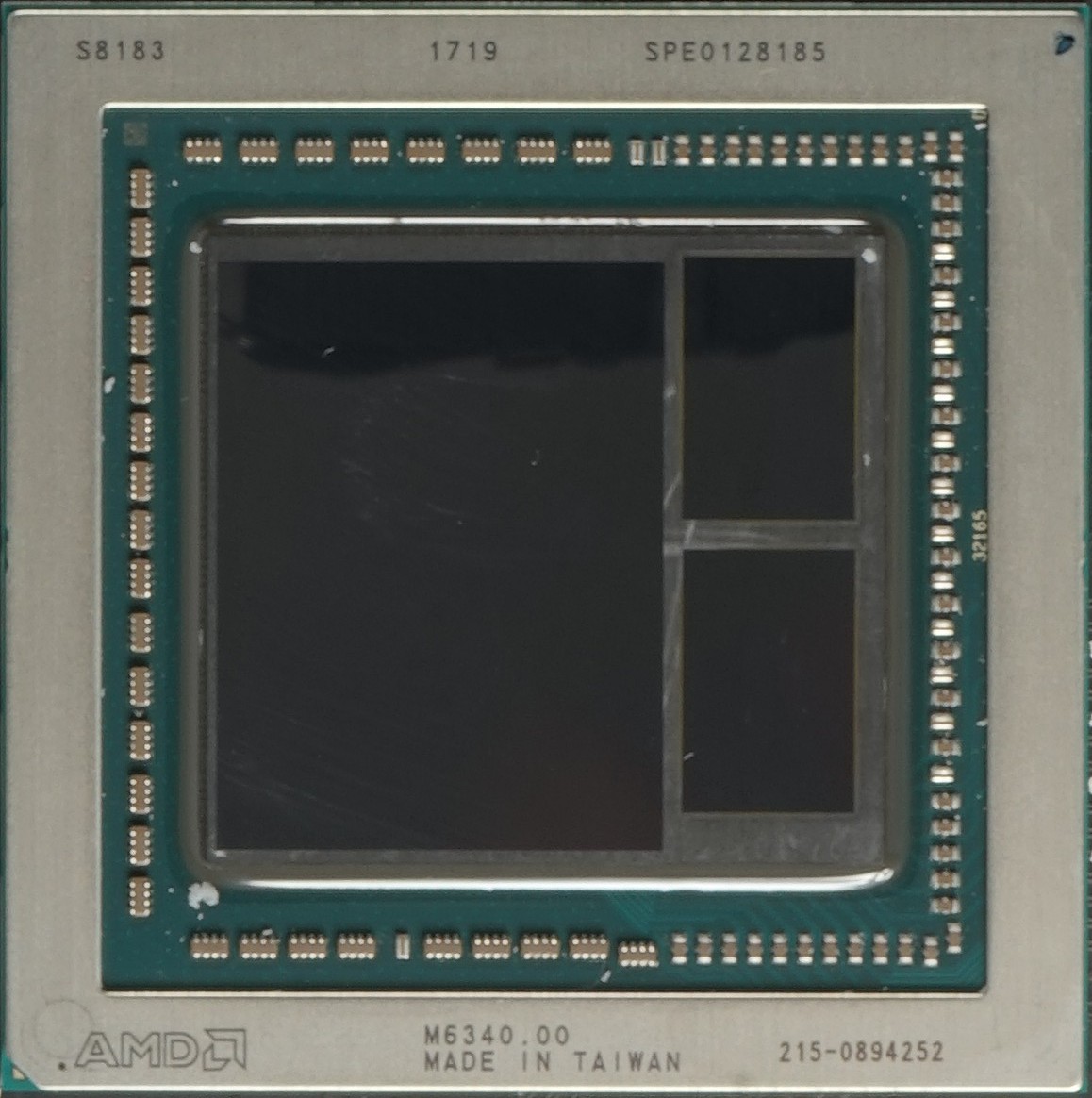 Variante Zwei: vergossen und wiederum made in Taiwan
Variante Zwei: vergossen und wiederum made in Taiwan
Eine dritte Variante kommt ins Spiel
Trotzdem nutzt AMD aktuell nachweislich beide Varianten des Packages (die mittlerweile von zwei verschiedenen Fertigern stammen) was einige AIB durchaus vor technischen Probleme stellen könnte, auf die wir gleich noch eingehen wollen. Doch was ist bei der dritten Variante anders, die wir z.B. auch unserer RX Vega56 vorgefunden haben? Mal abgesehen von leichten optischen Unterschieden beim Ring, der Platine und der Beschriftung, sind auch der Fabrikationsstandort und Fertiger abweichend.
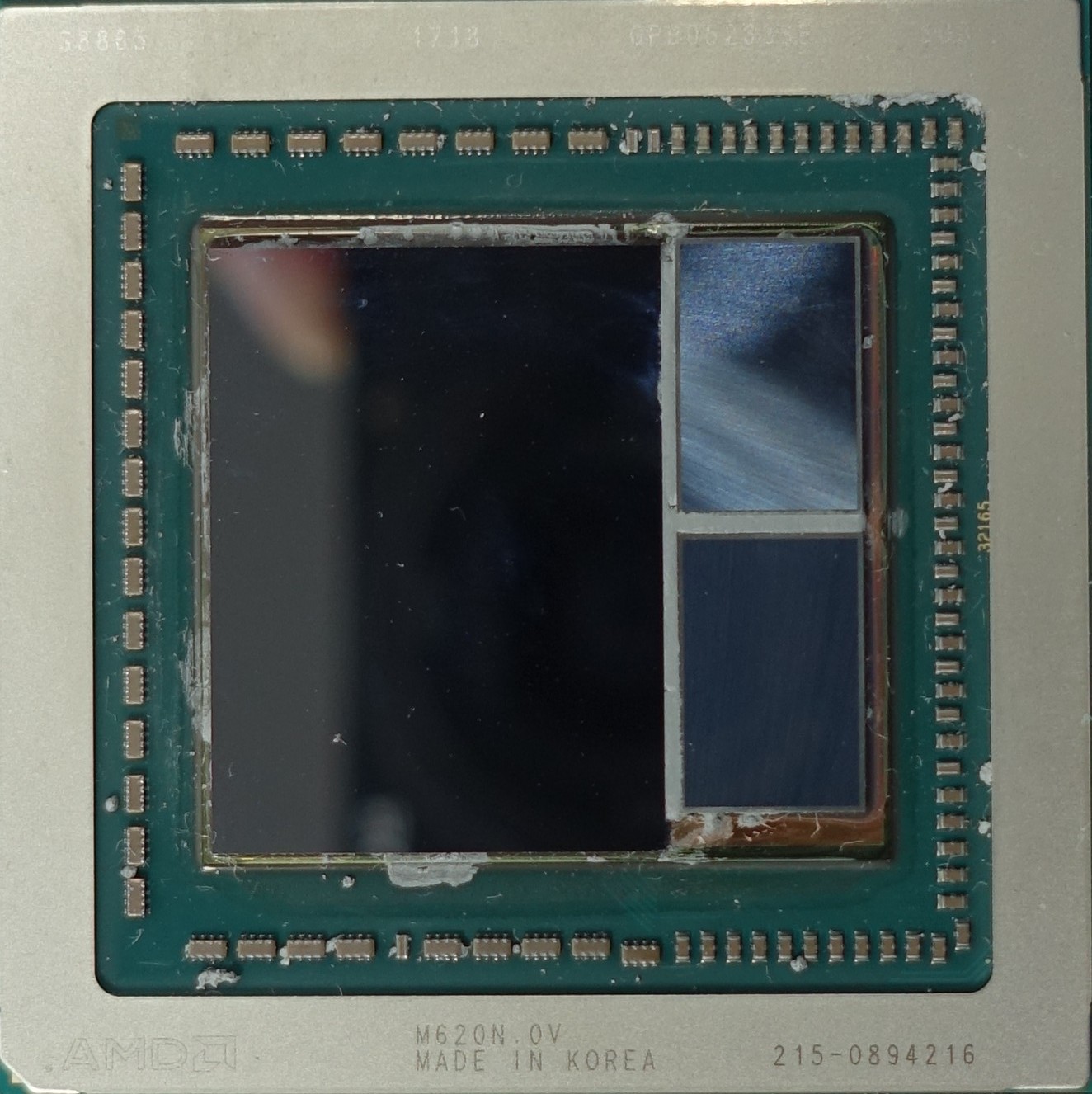 Variante Drei kommt aus Korea und stammt ganz offensichtlich nicht von ASE
Variante Drei kommt aus Korea und stammt ganz offensichtlich nicht von ASE
Erinnern wir uns mal ein wenig zurück. So war es in der Vergangenheit bei Fiji meist so, dass AMD nur die funktionierenden Chips zunächst an den Speicherlieferanten SK Hynix schickte und man dort funktionsfähige HBM-Module aufbrachte, das Packaging jedoch ohne Molding gleich in Korea erledigen ließ und erst dann das fertige Package zurück an AMD geschickt wurde. Die gemoldeten Packages auf unseren beiden zuvor getesteten Karten stammen von ASE auf Taiwan, hier kommt jetzt aber erneut ein koreanisches Packaging ins Spiel.
Wo aber liegt nun das Problem?
Da der HBM2 bei den ungemoldeten Packages um 40 μm tiefer liegt und auch der Underfill der dritten Variante offensichtlich etwas abweicht, stehen die AIB vor neuen Herausforderungen. Zum einen muss in der Massenproduktion und bei Verwendung eines gemeinsamen Kühlers für mehrere Modelle darauf geachtet werden, dass bei den ungemoldeten Packages die Dicke des aufgetragenen Wärmeleitmaterials optimiert werden muss, die Viskosität hoch genug sein muss und trotzdem der beim Verschrauben entstehende Anpressdruck nichts beschädigt.
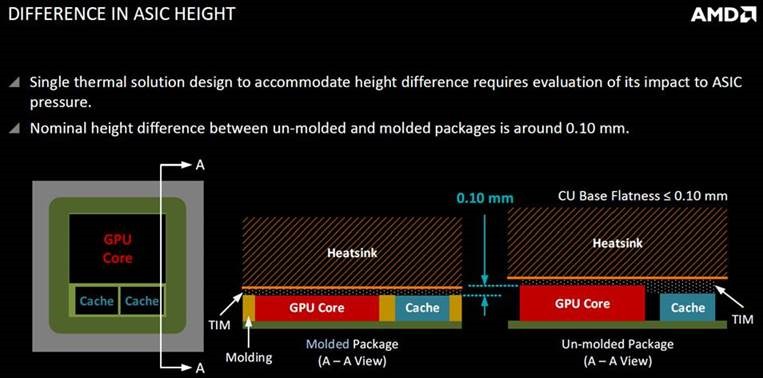
Wir haben im Eigenversuch beide PCBs gegeneinander verglichen, die Karten jeweils mit einen vordefinierten Power Limit so laufen lassen, dass sie im gleichen Gaming-Loop ca. 260 Watt an Leistung aufgenommen haben. Als Paste kamen dafür die etwas viskosere Diamond von Innovation Cooling im Vergleich mit der ziemlich dünnflüssigen Kryonaut von Thermal Grizzly zum Einsatz.
Um unter Last eine ähnliche Erwärmungskurve bei beiden Packages hinzubekommen, musste man bei der Diamond tatsächlich einen etwas höheren Anpressdruck für das niedrigere Package nutzen (zwischen ca. 0.05 und 0.1 Nm mehr). Da viele Herstellern zudem mit Stoppern arbeiten, um ein Überdrehen zu verhindern, kann dies zu einem Problem werden, wenn dann plötzlich das Drehmoment doch nicht mehr ausreicht, weil z.B. die Gewinde zu Ende sind.
Bei der deutlichen flüssigeren Kryonaut war es hingegen egal, welches der beiden Packages bei identischem Anpressdruck verwendet wurde. Nur ist es leider so, dass nicht so viskose Pasten eher nicht für den industriellen Einsatz mit vorkonfektioniertem Auftrag auf dem Heatsink geeignet sind.

Wir verfügen zudem über Informationen, nach denen einzelne Partner die Kühler-Heatsinks nunmehr sogar mit sechs, statt mit vier Schrauben befestigen (müssen) und dementsprechend auch alle bisher vorgefertigten Heatsinks und Backplates für die unvergossenen Packages angepasst werden mussten bzw. so nicht mehr nutzbar waren. Andere berichteten von SMT-Problemen und weiteren Anpassungen, was das Erscheinen einiger Custom-Modelle deshalb verschieben könnte.

AMD ließ auf Rückfragen gegenüber den Boardpartnern verlauten, dass die minimalen Unterschiede zwischen den Packages keinen Einfluss auf die Funktionalität der bereits entwickelten, individuellen Kühllösungen haben sollte. Doch selbst wenn sich dies als Tatsache erweist, müssen die Fertiger in eigenem Interesse zunächst eigene Testreihen fahren, um die Massenproduktion möglichst optimal vorzubereiten. Und dies kostet erneut Zeit, die eigentlich keiner hat. Waren die ersten Custom-Modelle bereits für Mitte September angekündigt, dürften sich einige Modelle nun eher bis Ende September oder Anfang Oktober hin verzögern.
Liegt es am unterschiedlichen Speicher?
Wir werden versuchen, noch weitere Details zu erfahren, denn die aktuellen Gerüchte reichen bis hin zur Verwendung verschiedener Speichermodule von Samsung und SK Hynix, je nach Package-Typ. Solange diesbezüglich jedoch keine belastbaren Äußerungen direkt Beteiligter vorliegen, bleibt dies vorerst natürlich rein spekulativ. Aber es wäre auch einer der möglichen Gründe, warum wir bei den Packages unterschiedliche Höhen der HBM2-Speichermodule verzeichnen können und warum es deshalb verschiedene Fertigungen gibt.
Es ist technisch zudem nicht einfach bzw. fast schon unmöglich, so unterschiedlich hohe Bauelemente sauber einzugießen, was ebenfalls für die Mutmaßung spricht, dass hier unterschiedliche Speichermodule zum Einsatz kommen könnten. Ein reines Kapazitätsproblem beim Packaging-Prozess dürfte man ja aktuell eigentlich ausschließen können.
 Auf einem der ungemoldeten Packages war noch ein Label auf dem HBM2 zu sehen
Auf einem der ungemoldeten Packages war noch ein Label auf dem HBM2 zu sehen
Update, 22.08.2017, 10:30 Uhr
Wie wir gerade aus recht sicherer Quelle erfahren haben, nutzt die RX Vega56 wohl nur ausschließlich den HBM2 von SK Hynix. Trotzdem sollen sich auch für die RX Vega56 zwei Package-Typen im Umlauf befinden, die von den AIB nicht separiert geordert werden können, so dass man sich eben nicht auf einen Package-Typ hin orientieren kann. Die 0,1 mm Höhenunterschied sind aber durchaus keine zu vernachlässigende Größe.
Wie relevant ist das Ganze?
Hier scheiden sich die Geister bei den Fertigern etwas, denn wer mit neueren, passenden Produktionsanlagen ausgestattet ist, hat weniger Probleme bei der Platinenfertigung. Bei den Kühlern hängt es hingegen von der individuellen Lösung ab, deren potentielle Änderung auch höhere Kosten bedeuten könnte, da vieles, was geplant war, noch einmal neu gelöst und hergestellt werden muss.
Ein wichtiger Faktor ist zusätzlich die Zeit, denn jeder verlorene Tag kostet bares Geld. Sollte noch unterschiedlicher HBM2-Speicher mit ins Spiel kommen, wird es interessant sein, die mögliche Übertaktbarkeit und Wärmeentwicklung der Module zu vergleichen. Wir bleiben hier auf alle Fälle dran.
















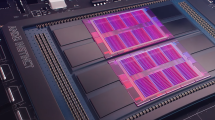














Kommentieren